等离子清洗的机理分类
空间内部的等离子体与材料表面发生反应是等离子体清洗的主要机理,其中反应大致可分为两种:一种是气体的自由基活性粒子与材料表面污染物发生化学反应;另一种是电离产生的正离子和电子轰击材料表面发生使污料表面脱落的物理反应,针对不同行业的清洗产品可选择相对应的工艺气体进行等离子表面清洗。
气体放电产生的等离子体中有电子、正离子、亚稳态的分子和原子等,当被清洗间浸没到等离子中时,等离子体种的化学活性粒子就与材料表面的污染物发生化学反应,如果是氢离子,反应为还原反应;如果是氧离子,则发生氧化反应。
下图分别是氧等离子体和氢等离子体清洗时反应的原理图,其中(a)表示氧等离子体反应的过程,可以看出,氧等离子体中的活性粒子与有机污染物发生化学反应,有机污染物被分解,生成了二氧化碳;(b)则表示氢等离子反应的过程,氢等离子体中的活性粒子与氧化物发生还原反应,氧化物被还原成水。
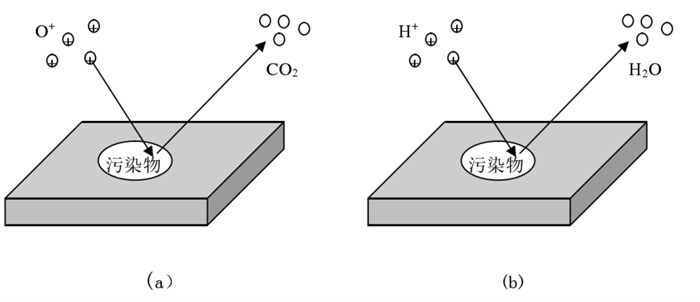
以氧气(O2)为例其方程式为:
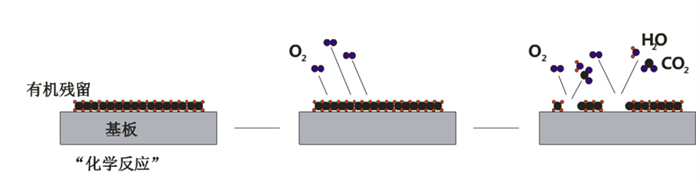
化学清洗具有清洗速度高,选择性好的特点,但是其在清洗过程中可能在被清洗表面重新产生氧化物,而氧化在半导体封装的引线键合工艺中是绝对不允许出现的,因此在引线键合工艺中若需要采用化学清洗,则需要严格控制化学清洗的工艺参数。
物理等离子清洗
在物理清洗里常用的气体为氩气。其作用机理是利用等离子体里的离子作纯物理的撞击,把材料表面的原子或附着材料表面的原子打掉,如下图所示。由于离子在压力较低时的平均自由基较长,有着能量的累积,因而在物理撞击时,离子的能量越高,越是有撞击的作用,所以若要以物理反应为主时,就必须控制较低的压力下来进行反应,这样清洗效果较好。其作用方程式为:
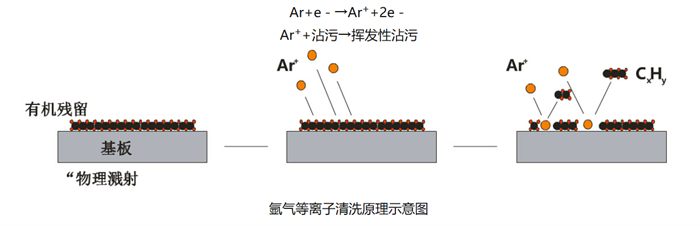
物理清洗是半导体封装工艺中最常用的等离子清洗方法。经过氩等离子清洗后,能够改变材料表面的微观形态,提高表面活性和附着性能,同时不会产生氧化物,对提高键合工艺的可靠性有很大的帮助。
综上所述,等离子清洗机清洗原理是在真空状态下使电极之间形成高频交变电场,区域内气体在交变电场的激荡下形成等离子体,活性等离子对被清洗物进行物理轰击与化学反应双重作用,使被清洗物表面沾污物质变成粒子和气态物质,经过抽真空排出,而达到清洗目的。

 400-880-3713
400-880-3713 在线咨询
在线咨询
