显影方法解析及常见显影方式
显影
用化学显影液溶解光刻胶经过曝光后可溶解区域的过程称为显影,其主要目的是将光刻板上的图形用光刻胶精确地复制到晶圆片上,即溶解掉不需要的光刻胶,从而在光刻胶膜上获得所需要的图形。
显影其实质是通过溶解光刻胶使图形进行复刻,对于不同的光刻胶有不同的复刻方式,对于正性光刻胶显影,曝光区域的光刻胶会产生光酸,以酚醛树脂-重氮奈醌为例,感光剂重氮奈醌在曝光作用下产生少量氮气,生成烯酮,烯酮与显影液中的水进一步反应成羧酸,碱性显影液溶解羧酸,从而使曝光区域溶解。曝光区与非曝光区对于显影液的溶解性约为1:4,即非曝光区的光刻胶在显影液过程中也会被溶解,显影时间过长会导致光刻胶过减薄,出现翘起或无法对蚀刻过程起到保护作用。即流膜率也是显影过程中必须考虑的因素。可以使用两种碱-水溶液或非离子溶液对正性光刻胶进行显影。碱-水溶液可以用氢氧化钾或者氢氧化钠,但这两种溶液都存在可动的离子污染物,所以在制造敏感的电路时无法使用;非离子溶液一般采用四甲基氢氧化铵(TMAH)溶液。停影过程使用高纯度的DI去除晶圆表面的显影液。对负性光刻胶,曝光区域发生交联反应,生成稳定的化学结构,使显影液无法溶解,即溶解区域为非曝光区域。大多数负光刻胶显影液为二甲苯,它还能被用作负光刻胶配方中的溶液,显影完成前还需要冲洗,通过使用n-醋酸丁酯作为冲洗剂,因为它既不会使光刻胶膨胀也不会使之收缩,从而不会导致图案失真。对具有台阶图案的晶圆,可使用更温和的stouddard溶剂。
显影液
正胶显影包含显影液与光刻胶之间的反应,从而溶解被曝光的光刻胶。显影液溶解光刻胶的速度称为显影速度,高的显影速度有助于生产效率的提高,但太高的显影速度又可能影响到光刻胶的特性。
正胶显影液是一种用水稀释的强碱溶液,早期的显影液为氢氧化钠或氢氧化钾的水溶液,但这两种溶液中都包含有金属,会造成可动离子沾污,对于污染很敏感的集成电路是不能接受的。目前最普通的正胶显影液是四甲基氢氧化铵(TMAH),这种显影液的金属离子浓度很低,从而避免了金属离子的污染。质量分数为2.38%左右的TMAH作为显影工业的标准被广泛应用于正性光刻胶的显影。
TMAH显影需要仔细控制溶液的pH值,同时显影液温度的控制也是很重要的。光刻胶的溶解速率随显影液温度的变化而变化,显影液温度越低,光刻胶的溶解速率就越快。通常,显影液中还会添加表面活性剂,用以减小表面张力,改善显影效果。
显影方法
a.浸没式显影:在耐化学腐蚀的容器中盛放显影液,将一盒晶圆片浸没在显影液中并进行一定幅度的振荡,浸入一定时间后取出晶圆片冲洗。伴随着光刻胶的溶解,显影液被不断稀释,需按经验跟换显影液。部分溶解的光刻胶会粘在晶圆表面,在晶圆取出时也会被化学液面污染,若处理不干净会对蚀刻工艺造成影响,缺陷多。室温的波动会影响晶圆不同区域的显影速度,浸入溶液时无法保证整版同时解除溶液造成与显影液接触时间不均,从而无法保证线宽均匀性。浸没式湿法显影还需要消耗大量的显影液,并且对于大尺寸的晶圆片来说,这种方法很难实现良好的显影均匀性。除了传统的浸没式显影外,现在被广泛应用的湿法显影技术有连续喷雾显影和旋覆浸没显影。
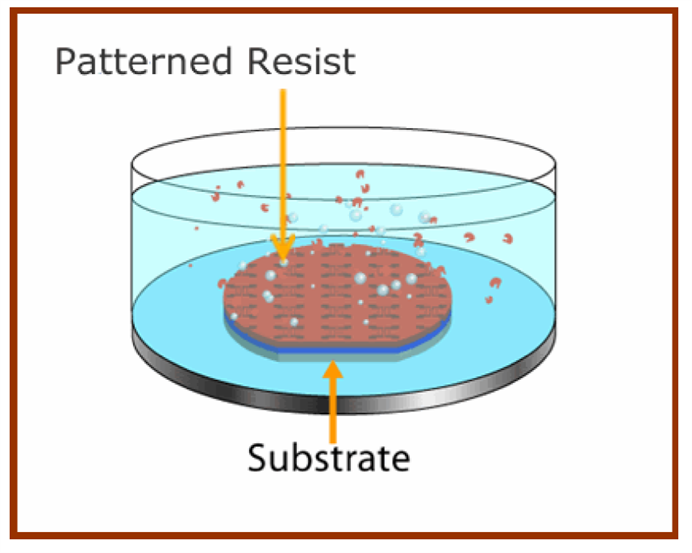
b.喷雾式显影:在晶圆表面上喷洒显影液,然后晶圆在静止的状态下进行显影。喷雾式显影可大大降低显影液的使用。喷雾式工艺可在单片或批量系统中完成。在单片晶圆配置中,晶圆被真空吸在吸盘上并旋转,同时显影液和冲洗液依次喷射到晶圆表面。冲洗之后,立即提高晶圆吸盘旋转速度将晶圆甩干。在外观和设计上,单晶圆喷雾式系统和旋转式涂胶机一样只是通入不同的化学品。单晶圆喷雾式系统具有集成显影和硬烘工艺而实现自动化的优点。这些工艺系统的一个主要优点是直接喷洒到晶圆表面的化学品的均匀性的提高。
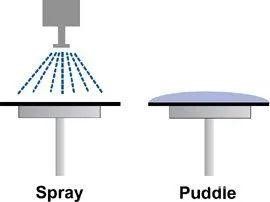
c.旋覆浸没显影:旋覆浸没显影与喷雾显影的设备基本相同,喷到晶圆片表面的显影液的量要多一些,通过低速旋转能够覆盖晶圆表面。在所有操作中,为了让可溶解区域充分溶解,显影液必须在光刻胶上停留足够的时间。光刻胶被显影液溶解后再用去离子水清洗晶圆片表面并旋转甩干。为了获得良好的显影效果,有些厂家也采用多次旋覆浸没的办法。相对传统显影方式而言,旋覆浸没显影的每一片晶圆使用的都是新的显影液,提高了晶圆片间的均匀性,并且旋覆浸没显影减小了温度的影响,实现了对显影均匀性的良好控制。
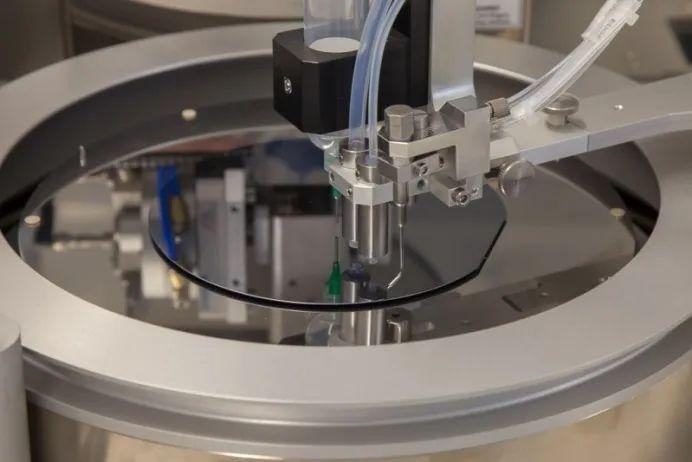

 400-880-3713
400-880-3713 在线咨询
在线咨询
